For many years, UV-VIS-NIR modular spectrometers have been used to measure thin films on surface. For example, in order to measure the transmittance and reflectance off a silicon wafer’s surface, the destructive and constructive interference can be measured and the films’ thickness can be calculated down to tens of Angstroms (up to several layers).
Given their quick scan speed, flexibility of using fiber optic probes, and repeatability, modern spectrometer modules are ideal for this application.

Figure 1. Silicon wafers
B&W Tek’s Exemplar series spectrometers come with features that make the measurement of thin films an easy, quick, and accurate process. These spectrometers have a low integration time of 1 ms and a low trigger delay of less than 95 ns (±20 jitter). The Exemplar spectrometers are repeatable and fast by OEM module standards, and can be easily implemented using B&W Tek’s software development kit (SDK) (Figure 2).
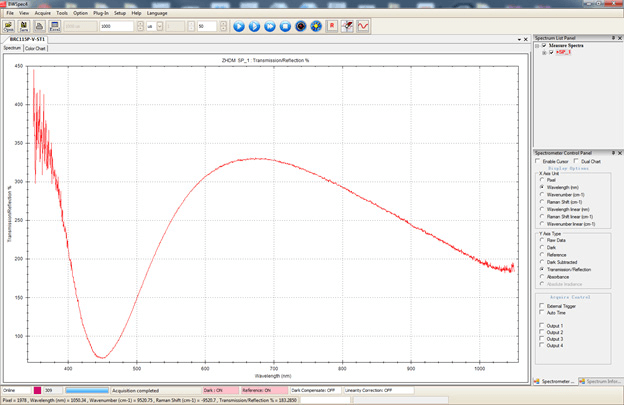
Figure 2. BWSpec® Mobile Enhanced Mobile Spectral Data Acquisition Software
Key Advantages of the Exemplar Series
The Exemplar spectrometers offer numerous advantages, including a low integration time of 1 ms; an in-built microprocessor for on-board spectral processing; and a low external trigger delay of 35 ns ± 5 ns jitter. The spectrometers also come with USB 3.0 that facilitates high-speed data transfer.
The multi-channel capabilities can support as many as 32 spectrometers without the need for additional hardware. Additionally, the spectrometer’s capabilities can be completely controlled by the SDK.
Other Essential Equipment
In order to conduct high-quality measurements within a short period, it is essential to have a Tungsten Deuterium/Tungsten Halogen Source, a fiber reflectance probe holder (FRPH), a Exemplar series spectrometer (UV-VIS-NIR), a software development kit (SDK-S), and a fiber reflectance probe or bifurcated fiber assembly (FRP/BRS).

Figure 3. Measurement of reflectance off the surface of a silicon wafer using Exemplar series spectrometer, and other equipment.

This information has been sourced, reviewed and adapted from materials provided by B&W Tek.
For more information on this source, please visit B&W Tek.